
- English
- Español
- Português
- русский
- Français
- 日本語
- Deutsch
- tiếng Việt
- Italiano
- Nederlands
- ภาษาไทย
- Polski
- 한국어
- Svenska
- magyar
- Malay
- বাংলা ভাষার
- Dansk
- Suomi
- हिन्दी
- Pilipino
- Türkçe
- Gaeilge
- العربية
- Indonesia
- Norsk
- تمل
- český
- ελληνικά
- український
- Javanese
- فارسی
- தமிழ்
- తెలుగు
- नेपाली
- Burmese
- български
- ລາວ
- Latine
- Қазақша
- Euskal
- Azərbaycan
- Slovenský jazyk
- Македонски
- Lietuvos
- Eesti Keel
- Română
- Slovenski
- मराठी
- Srpski језик
Eine vollständige Erklärung des Chip-Herstellungsprozesses (1/2): vom Wafer bis zur Verpackung und Prüfung
2024-09-18
Die Herstellung jedes Halbleiterprodukts erfordert Hunderte von Prozessen und der gesamte Herstellungsprozess ist in acht Schritte unterteilt:Waferverarbeitung - Oxidation - Fotolithographie - Radierung - Dünnschichtabscheidung - Zusammenschaltung - Testen - Verpackung.
![]()
Schritt 1:Waferverarbeitung
Alle Halbleiterprozesse beginnen mit einem Sandkorn! Denn das im Sand enthaltene Silizium ist der Rohstoff, der zur Herstellung von Wafern benötigt wird. Wafer sind runde Scheiben, die aus Einkristallzylindern aus Silizium (Si) oder Galliumarsenid (GaAs) geschnitten werden. Um hochreine Siliziummaterialien zu gewinnen, wird Quarzsand benötigt, ein Spezialmaterial mit einem Siliziumdioxidgehalt von bis zu 95 %, der auch der Hauptrohstoff für die Herstellung von Wafern ist. Bei der Waferverarbeitung handelt es sich um den Prozess der Herstellung der oben genannten Wafer.
Barrenguss
Zunächst muss der Sand erhitzt werden, um das darin enthaltene Kohlenmonoxid und Silizium zu trennen. Der Vorgang wird wiederholt, bis ultrahochreines Silizium in Elektronikqualität (EG-Si) erhalten wird. Hochreines Silizium schmilzt zu einer Flüssigkeit und verfestigt sich dann zu einer einkristallinen festen Form, einem sogenannten „Ingot“, was den ersten Schritt in der Halbleiterherstellung darstellt.
Die Herstellungsgenauigkeit von Siliziumbarren (Siliziumsäulen) ist sehr hoch und erreicht den Nanometerbereich. Die am weitesten verbreitete Herstellungsmethode ist die Czochralski-Methode.
Schneiden von Barren
Nachdem der vorherige Schritt abgeschlossen ist, müssen die beiden Enden des Barrens mit einer Diamantsäge abgeschnitten und anschließend in dünne Scheiben einer bestimmten Dicke geschnitten werden. Der Durchmesser der Ingotscheibe bestimmt die Größe des Wafers. Größere und dünnere Wafer können in besser nutzbare Einheiten aufgeteilt werden, was zur Reduzierung der Produktionskosten beiträgt. Nach dem Schneiden des Siliziumbarrens ist es notwendig, Markierungen für „flache Bereiche“ oder „Dellen“ auf den Scheiben anzubringen, um die Festlegung der Verarbeitungsrichtung als Standard in den nachfolgenden Schritten zu erleichtern.
Polieren der Waferoberfläche
Die durch den oben genannten Schneidvorgang erhaltenen Scheiben werden „Bare Wafers“ genannt, also unbearbeitete „Rohwaffeln“. Die Oberfläche des blanken Wafers ist uneben und das Schaltkreismuster kann nicht direkt darauf gedruckt werden. Daher ist es notwendig, zunächst Oberflächendefekte durch Schleif- und chemische Ätzprozesse zu entfernen, dann zu polieren, um eine glatte Oberfläche zu erhalten, und anschließend restliche Verunreinigungen durch Reinigen zu entfernen, um einen fertigen Wafer mit einer sauberen Oberfläche zu erhalten.
Schritt 2: Oxidation
Die Aufgabe des Oxidationsprozesses besteht darin, einen Schutzfilm auf der Oberfläche des Wafers zu bilden. Es schützt den Wafer vor chemischen Verunreinigungen, verhindert das Eindringen von Leckströmen in den Stromkreis, verhindert die Diffusion während der Ionenimplantation und verhindert, dass der Wafer beim Ätzen verrutscht.
Der erste Schritt des Oxidationsprozesses besteht darin, Verunreinigungen und Verunreinigungen zu entfernen. Es sind vier Schritte erforderlich, um organische Stoffe und Metallverunreinigungen zu entfernen und Restwasser zu verdampfen. Nach der Reinigung kann der Wafer in eine Hochtemperaturumgebung von 800 bis 1200 Grad Celsius gebracht werden, und durch den Fluss von Sauerstoff oder Dampf auf der Oberfläche des Wafers bildet sich eine Siliziumdioxidschicht (d. h. „Oxid“). Sauerstoff diffundiert durch die Oxidschicht und reagiert mit Silizium, um eine Oxidschicht unterschiedlicher Dicke zu bilden, deren Dicke nach Abschluss der Oxidation gemessen werden kann.

Trockenoxidation und Nassoxidation Abhängig von den verschiedenen Oxidationsmitteln in der Oxidationsreaktion kann der thermische Oxidationsprozess in Trockenoxidation und Nassoxidation unterteilt werden. Ersteres verwendet reinen Sauerstoff, um langsam eine Siliziumdioxidschicht zu erzeugen, die Oxidschicht ist jedoch dünn und dicht. Letzteres erfordert sowohl Sauerstoff als auch gut löslichen Wasserdampf, der sich durch eine schnelle Wachstumsrate, aber eine relativ dicke Schutzschicht mit geringer Dichte auszeichnet.
Neben dem Oxidationsmittel gibt es noch andere Variablen, die die Dicke der Siliziumdioxidschicht beeinflussen. Erstens beeinflussen die Waferstruktur, ihre Oberflächendefekte und die interne Dotierungskonzentration die Geschwindigkeit der Oxidschichtbildung. Darüber hinaus wird die Oxidschicht umso schneller erzeugt, je höher der von der Oxidationsanlage erzeugte Druck und die Temperatur sind. Während des Oxidationsprozesses ist es außerdem erforderlich, entsprechend der Position des Wafers in der Einheit eine Blindfolie zu verwenden, um den Wafer zu schützen und den Unterschied im Oxidationsgrad zu verringern.
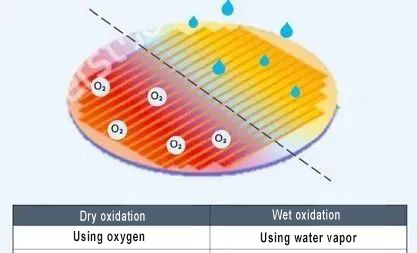
Schritt 3: Fotolithographie
Bei der Fotolithographie wird das Schaltungsmuster durch Licht auf den Wafer „gedruckt“. Wir können es so verstehen, dass wir die für die Halbleiterfertigung erforderliche ebene Karte auf die Oberfläche des Wafers zeichnen. Je feiner das Schaltungsmuster ist, desto höher ist die Integration des fertigen Chips, die durch fortschrittliche Fotolithographietechnologie erreicht werden muss. Konkret kann die Fotolithographie in drei Schritte unterteilt werden: Beschichten des Fotolacks, Belichtung und Entwicklung.
Beschichtung
Der erste Schritt beim Zeichnen einer Schaltung auf einem Wafer besteht darin, den Fotolack auf die Oxidschicht aufzutragen. Fotolack macht den Wafer zu einem „Fotopapier“, indem er seine chemischen Eigenschaften verändert. Je dünner die Fotolackschicht auf der Oberfläche des Wafers ist, desto gleichmäßiger ist die Beschichtung und desto feiner ist das Muster, das gedruckt werden kann. Dieser Schritt kann durch das „Spin-Coating“-Verfahren erfolgen. Aufgrund des Unterschieds in der Lichtreaktivität (Ultraviolett) können Fotolacke in zwei Typen unterteilt werden: positive und negative. Ersteres zersetzt sich und verschwindet nach Lichteinwirkung und hinterlässt das Muster des unbelichteten Bereichs, während Letzteres nach Lichteinwirkung polymerisiert und das Muster des belichteten Teils erscheinen lässt.
Belichtung
Nachdem der Fotolackfilm auf den Wafer aufgetragen wurde, kann der Schaltungsdruck durch Steuerung der Belichtung abgeschlossen werden. Dieser Vorgang wird als „Belichtung“ bezeichnet. Wir können Licht selektiv durch die Belichtungsausrüstung leiten. Wenn das Licht durch die Maske mit dem Schaltkreismuster fällt, kann der Schaltkreis auf den Wafer gedruckt werden, der mit dem darunter liegenden Fotolackfilm beschichtet ist.
Je feiner das gedruckte Muster während des Belichtungsprozesses ist, desto mehr Komponenten kann der endgültige Chip aufnehmen, was dazu beiträgt, die Produktionseffizienz zu verbessern und die Kosten für jede Komponente zu senken. Die neue Technologie, die in diesem Bereich derzeit große Aufmerksamkeit erregt, ist die EUV-Lithographie. Die Lam Research Group hat gemeinsam mit den strategischen Partnern ASML und imec eine neue Trockenfilm-Fotoresist-Technologie entwickelt. Diese Technologie kann die Produktivität und Ausbeute des EUV-Lithographie-Belichtungsprozesses erheblich verbessern, indem sie die Auflösung verbessert (ein Schlüsselfaktor bei der Feinabstimmung der Schaltkreisbreite).
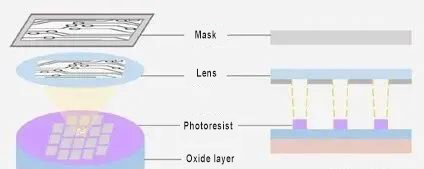
Entwicklung
Der Schritt nach der Belichtung besteht darin, den Entwickler auf den Wafer zu sprühen. Der Zweck besteht darin, den Fotolack im unbedeckten Bereich des Musters zu entfernen, so dass das Muster der gedruckten Schaltung freigelegt werden kann. Nach Abschluss der Entwicklung muss diese mit verschiedenen Messgeräten und optischen Mikroskopen überprüft werden, um die Qualität des Schaltplans sicherzustellen.
Schritt 4: Ätzen
Nachdem die Fotolithographie des Schaltplans auf dem Wafer abgeschlossen ist, wird ein Ätzprozess verwendet, um überschüssigen Oxidfilm zu entfernen und nur den Halbleiterschaltplan übrig zu lassen. Hierzu wird Flüssigkeit, Gas oder Plasma verwendet, um die ausgewählten überschüssigen Teile zu entfernen. Abhängig von den verwendeten Substanzen gibt es zwei Hauptmethoden zum Ätzen: Nassätzen, bei dem eine bestimmte chemische Lösung chemisch reagiert, um den Oxidfilm zu entfernen, und Trockenätzen mit Gas oder Plasma.
Nassätzung
Das Nassätzen mit chemischen Lösungen zur Entfernung von Oxidfilmen bietet die Vorteile niedriger Kosten, schneller Ätzgeschwindigkeit und hoher Produktivität. Allerdings ist das Nassätzen isotrop, das heißt, seine Geschwindigkeit ist in jede Richtung gleich. Dies führt dazu, dass die Maske (oder der empfindliche Film) nicht vollständig mit dem geätzten Oxidfilm ausgerichtet ist, sodass es schwierig ist, sehr feine Schaltpläne zu verarbeiten.

Trockenätzung
Das Trockenätzen kann in drei verschiedene Arten unterteilt werden. Das erste ist das chemische Ätzen, bei dem Ätzgase (hauptsächlich Fluorwasserstoff) zum Einsatz kommen. Dieses Verfahren ist wie das Nassätzen isotrop und daher nicht für die Feinätzung geeignet.
Die zweite Methode ist das physikalische Sputtern, bei dem Ionen im Plasma auf die überschüssige Oxidschicht treffen und diese entfernen. Als anisotropes Ätzverfahren weist das Sputterätzen unterschiedliche Ätzraten in horizontaler und vertikaler Richtung auf und ist daher auch feiner als das chemische Ätzen. Der Nachteil dieser Methode besteht jedoch darin, dass die Ätzgeschwindigkeit langsam ist, da sie vollständig auf der physikalischen Reaktion beruht, die durch die Ionenkollision verursacht wird.
Die letzte dritte Methode ist das reaktive Ionenätzen (RIE). RIE kombiniert die ersten beiden Methoden, d. h. während das physikalische Ionisierungsätzen mit Plasma erfolgt, wird das chemische Ätzen mit Hilfe freier Radikale durchgeführt, die nach der Plasmaaktivierung erzeugt werden. Zusätzlich zu der Ätzgeschwindigkeit, die die der ersten beiden Methoden übertrifft, kann RIE die anisotropen Eigenschaften von Ionen nutzen, um eine hochpräzise Musterätzung zu erreichen.
Heutzutage wird Trockenätzen häufig eingesetzt, um die Ausbeute feiner Halbleiterschaltkreise zu verbessern. Die Aufrechterhaltung einer gleichmäßigen Ätzung des gesamten Wafers und eine Erhöhung der Ätzgeschwindigkeit sind von entscheidender Bedeutung, und die modernsten Trockenätzanlagen von heute unterstützen die Produktion modernster Logik- und Speicherchips mit höherer Leistung.

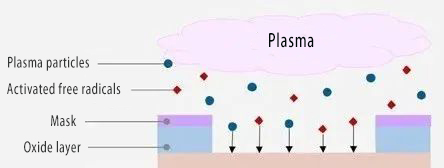
VeTek Semiconductor ist ein professioneller chinesischer Hersteller vonTantalcarbid-Beschichtung, Siliziumkarbidbeschichtung, Spezialgraphit, SiliziumkarbidkeramikUndAndere Halbleiterkeramiken. VeTek Semiconductor ist bestrebt, fortschrittliche Lösungen für verschiedene SiC-Wafer-Produkte für die Halbleiterindustrie bereitzustellen.
Wenn Sie an den oben genannten Produkten interessiert sind, können Sie sich gerne direkt an uns wenden.
Mob: +86-180 6922 0752
WhatsApp: +86 180 6922 0752
E-Mail: anny@veteksemi.com




