
- English
- Español
- Português
- русский
- Français
- 日本語
- Deutsch
- tiếng Việt
- Italiano
- Nederlands
- ภาษาไทย
- Polski
- 한국어
- Svenska
- magyar
- Malay
- বাংলা ভাষার
- Dansk
- Suomi
- हिन्दी
- Pilipino
- Türkçe
- Gaeilge
- العربية
- Indonesia
- Norsk
- تمل
- český
- ελληνικά
- український
- Javanese
- فارسی
- தமிழ்
- తెలుగు
- नेपाली
- Burmese
- български
- ລາວ
- Latine
- Қазақша
- Euskal
- Azərbaycan
- Slovenský jazyk
- Македонски
- Lietuvos
- Eesti Keel
- Română
- Slovenski
- मराठी
- Srpski језик
Basierend auf der 8-Zoll-Siliziumkarbid-Einkristall-Wachstumsofentechnologie
2024-07-11
Siliziumkarbid ist eines der idealen Materialien für die Herstellung von Hochtemperatur-, Hochfrequenz-, Hochleistungs- und Hochspannungsgeräten. Um die Produktionseffizienz zu verbessern und die Kosten zu senken, ist die Herstellung großformatiger Siliziumkarbidsubstrate eine wichtige Entwicklungsrichtung. Ausrichtung auf die Prozessanforderungen von8-Zoll-Einkristallwachstum aus Siliziumkarbid (SIC)., der Wachstumsmechanismus der physikalischen Dampftransportmethode (PVT) von Siliziumkarbid wurde analysiert, das Heizsystem (TaC-Führungsring, TaC-beschichteter Tiegel,TaC-beschichtete Ringe, TaC-beschichtete Platte, TaC-beschichteter dreiblättriger Ring, TaC-beschichteter dreiblättriger Tiegel, TaC-beschichteter Halter, poröser Graphit, weicher Filz, SiC-beschichteter Kristallwachstumssuszeptor aus starrem Filz und andereErsatzteile für den SiC-Einkristall-Züchtungsprozesswerden von VeTek Semiconductor bereitgestellt), wurden die Tiegelrotation und die Prozessparameter-Steuerungstechnologie des Siliziumkarbid-Einkristall-Züchtungsofens untersucht, und 8-Zoll-Kristalle wurden erfolgreich durch thermische Feldsimulationsanalyse und Prozessexperimente hergestellt und gezüchtet.
0 Einführung
Siliziumkarbid (SiC) ist ein typischer Vertreter der Halbleitermaterialien der dritten Generation. Es bietet Leistungsvorteile wie eine größere Bandlückenbreite, ein höheres elektrisches Durchbruchfeld und eine höhere Wärmeleitfähigkeit. Es funktioniert gut in Hochtemperatur-, Hochdruck- und Hochfrequenzfeldern und hat sich zu einer der Hauptentwicklungsrichtungen auf dem Gebiet der Halbleitermaterialtechnologie entwickelt. Es hat ein breites Anwendungsspektrum in Fahrzeugen mit neuer Energie, Photovoltaik-Stromerzeugung, Schienenverkehr, Smart Grid, 5G-Kommunikation, Satelliten, Radar und anderen Bereichen. Gegenwärtig nutzt das industrielle Wachstum von Siliziumkarbidkristallen hauptsächlich den physikalischen Dampftransport (PVT), der komplexe multiphysikalische Feldkopplungsprobleme mit Mehrphasen-, Mehrkomponenten-, Mehrfachwärme- und Stoffübertragung sowie magnetoelektrischer Wärmeflusswechselwirkung mit sich bringt. Daher ist der Entwurf des PVT-Wachstumssystems sowie die Messung und Steuerung der Prozessparameter während des Wachstums schwierigKristallwachstumsprozessist schwierig, was zu Schwierigkeiten bei der Kontrolle der Qualitätsmängel der gezüchteten Siliziumkarbidkristalle und der geringen Kristallgröße führt, so dass die Kosten von Vorrichtungen mit Siliziumkarbid als Substrat hoch bleiben.
Geräte zur Herstellung von Siliziumkarbid bilden die Grundlage der Siliziumkarbid-Technologie und der industriellen Entwicklung. Das technische Niveau, die Prozessfähigkeit und die unabhängige Garantie des Siliziumkarbid-Einkristall-Wachstumsofens sind der Schlüssel für die Entwicklung von Siliziumkarbidmaterialien in Richtung großer Größe und hoher Ausbeute und sind auch die Hauptfaktoren, die die Halbleiterindustrie der dritten Generation vorantreiben sich in Richtung kostengünstig und großräumig entwickeln. Gegenwärtig hat die Entwicklung von Hochspannungs-, Hochleistungs- und Hochfrequenz-Siliziumkarbidgeräten erhebliche Fortschritte gemacht, aber die Produktionseffizienz und die Herstellungskosten von Geräten werden zu einem wichtigen Faktor, der ihre Entwicklung einschränkt. Bei Halbleiterbauelementen mit Siliziumkarbid-Einkristallen als Substrat macht der Substratwert mit etwa 50 % den größten Anteil aus. Die Entwicklung großformatiger, hochwertiger Siliziumkarbid-Kristallzüchtungsanlagen, die Verbesserung der Ausbeute und Wachstumsrate von Siliziumkarbid-Einkristallsubstraten und die Reduzierung der Produktionskosten sind von zentraler Bedeutung für die Anwendung entsprechender Geräte. Um das Angebot an Produktionskapazitäten zu erhöhen und die durchschnittlichen Kosten von Siliziumkarbid-Geräten weiter zu senken, ist die Vergrößerung der Siliziumkarbid-Substrate eine der wichtigsten Möglichkeiten. Derzeit beträgt die international gängige Siliziumkarbid-Substratgröße 6 Zoll und hat sich rasch auf 8 Zoll weiterentwickelt.
Zu den wichtigsten Technologien, die bei der Entwicklung von 8-Zoll-Öfen für die Züchtung von Siliziumkarbid-Einkristallen gelöst werden müssen, gehören: 1) Entwurf einer großen Wärmefeldstruktur, um einen kleineren radialen Temperaturgradienten und einen größeren longitudinalen Temperaturgradienten zu erhalten, der für das Wachstum geeignet ist aus 8-Zoll-Siliziumkarbidkristallen. 2) Großer Mechanismus zum Drehen des Tiegels und Heben und Senken der Spule, so dass sich der Tiegel während des Kristallwachstumsprozesses dreht und sich entsprechend den Prozessanforderungen relativ zur Spule bewegt, um die Konsistenz des 8-Zoll-Kristalls sicherzustellen und Wachstum und Dicke zu erleichtern . 3) Automatische Steuerung der Prozessparameter unter dynamischen Bedingungen, die den Anforderungen eines hochwertigen Einkristallwachstumsprozesses entsprechen.
1 PVT-Kristallwachstumsmechanismus
Bei der PVT-Methode werden Siliziumkarbid-Einkristalle hergestellt, indem die SiC-Quelle am Boden eines zylindrischen Tiegels aus dichtem Graphit platziert wird und der SiC-Keimkristall in der Nähe des Tiegeldeckels platziert wird. Der Tiegel wird durch Hochfrequenzinduktion oder Widerstand auf 2.300 bis 2.400 °C erhitzt und ist mit Graphitfilz isoliertporöser Graphit. Die Hauptstoffe, die von der SiC-Quelle zum Impfkristall transportiert werden, sind Si, Si2C-Moleküle und SiC2. Die Temperatur am Impfkristall wird so gesteuert, dass sie etwas niedriger ist als die am unteren Mikropulver, und im Tiegel entsteht ein axialer Temperaturgradient. Wie in Abbildung 1 dargestellt, sublimiert das Siliziumkarbid-Mikropulver bei hoher Temperatur, um Reaktionsgase aus verschiedenen Gasphasenkomponenten zu bilden, die unter dem Antrieb des Temperaturgradienten den Impfkristall mit einer niedrigeren Temperatur erreichen und darauf zu einem Zylinder kristallisieren Siliziumkarbid-Barren.
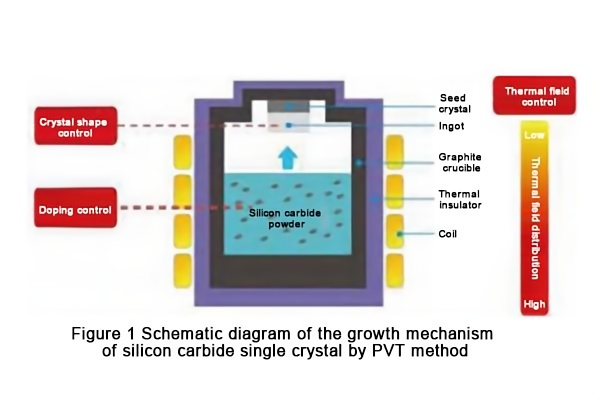
Die wichtigsten chemischen Reaktionen des PVT-Wachstums sind:
SiC(s)⇌Si(g)+C(s) (1)
2SiC⇌Si2C(g)+C(s) (2)
2SiC⇌SiC2(g)+Si(l,g) (3)
SiC(s)⇌SiC(g) (4)
Die Merkmale des PVT-Wachstums von SiC-Einkristallen sind:
1) Es gibt zwei Gas-Feststoff-Grenzflächen: eine ist die Gas-SiC-Pulver-Grenzfläche und die andere ist die Gas-Kristall-Grenzfläche.
2) Die Gasphase besteht aus zwei Arten von Substanzen: zum einen aus den in das System eingeführten inerten Molekülen; das andere ist die Gasphasenkomponente SimCn, die durch Zersetzung und Sublimation entstehtSiC-Pulver. Die Gasphasenkomponenten SimCn interagieren miteinander und ein Teil der sogenannten kristallinen Gasphasenkomponenten SimCn, die die Anforderungen des Kristallisationsprozesses erfüllen, wächst in den SiC-Kristall ein.
3) Im festen Siliziumkarbidpulver treten Festphasenreaktionen zwischen nicht sublimierten Partikeln auf, darunter einige Partikel, die durch Sintern poröse Keramikkörper bilden, einige Partikel, die durch Kristallisationsreaktionen Körner mit einer bestimmten Partikelgröße und kristallografischen Morphologie bilden, und einige Siliziumkarbidpartikel verwandeln sich aufgrund nichtstöchiometrischer Zersetzung und Sublimation in kohlenstoffreiche Partikel oder Kohlenstoffpartikel.
4) Während des Kristallwachstumsprozesses treten zwei Phasenänderungen auf: Zum einen werden die festen Siliziumkarbidpulverpartikel durch nichtstöchiometrische Zersetzung und Sublimation in die Gasphasenkomponenten SimCn umgewandelt, zum anderen werden die Gasphasenkomponenten SimCn umgewandelt durch Kristallisation in Gitterpartikel umgewandelt.
2 Gerätedesign Wie in Abbildung 2 dargestellt, umfasst der Siliziumkarbid-Einkristall-Züchtungsofen hauptsächlich: obere Abdeckungsbaugruppe, Kammerbaugruppe, Heizsystem, Tiegeldrehmechanismus, untere Abdeckungs-Hebemechanismus und elektrisches Steuerungssystem.

2.1 Heizsystem Wie in Abbildung 3 dargestellt, verwendet das Heizsystem eine Induktionsheizung und besteht aus einer Induktionsspule, aGraphittiegel, eine Isolationsschicht(starrer Filz, weicher Filz) usw. Wenn der mittelfrequente Wechselstrom durch die Induktionsspule mit mehreren Windungen fließt, die die Außenseite des Graphittiegels umgibt, wird im Graphittiegel ein induziertes Magnetfeld derselben Frequenz gebildet, das eine induzierte elektromotorische Kraft erzeugt. Da das Tiegelmaterial aus hochreinem Graphit eine gute Leitfähigkeit aufweist, wird an der Tiegelwand ein induzierter Strom erzeugt, der einen Wirbelstrom bildet. Unter der Wirkung der Lorentzkraft wird der induzierte Strom schließlich an der Außenwand des Tiegels konvergieren (d. h. der Skin-Effekt) und in radialer Richtung allmählich schwächer werden. Aufgrund der Existenz von Wirbelströmen wird an der Außenwand des Tiegels Joulesche Wärme erzeugt, die zur Heizquelle des Wachstumssystems wird. Die Größe und Verteilung der Joule-Wärme bestimmen direkt das Temperaturfeld im Tiegel, das wiederum das Wachstum des Kristalls beeinflusst.
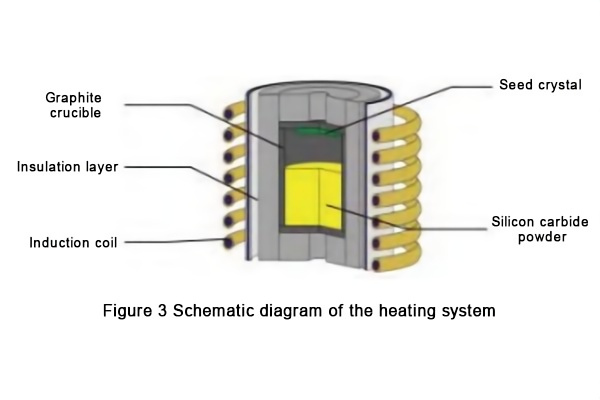
Wie in Abbildung 4 dargestellt, ist die Induktionsspule ein wichtiger Bestandteil des Heizsystems. Es verfügt über zwei Sätze unabhängiger Spulenstrukturen und ist jeweils mit oberen und unteren Präzisionsbewegungsmechanismen ausgestattet. Der größte Teil des elektrischen Wärmeverlusts des gesamten Heizsystems wird von der Spule getragen und es muss eine Zwangskühlung durchgeführt werden. Die Spule ist mit einem Kupferrohr umwickelt und wird im Inneren durch Wasser gekühlt. Der Frequenzbereich des induzierten Stroms beträgt 8–12 kHz. Die Frequenz der Induktionserwärmung bestimmt die Eindringtiefe des elektromagnetischen Feldes in den Graphittiegel. Der Spulenbewegungsmechanismus verwendet einen motorbetriebenen Schraubenpaarmechanismus. Die Induktionsspule arbeitet mit der Induktionsstromversorgung zusammen, um den inneren Graphittiegel zu erhitzen und so die Sublimation des Pulvers zu erreichen. Gleichzeitig werden die Leistung und die relative Position der beiden Spulensätze so gesteuert, dass die Temperatur am Impfkristall niedriger ist als die am unteren Mikropulver, wodurch ein axialer Temperaturgradient zwischen dem Impfkristall und dem Pulver im Mikropulver entsteht Tiegel und die Bildung eines angemessenen radialen Temperaturgradienten am Siliziumkarbidkristall.

2.2 Rotationsmechanismus des Tiegels während des Wachstums großer MengenSiliziumkarbid-Einkristalle, der Tiegel in der Vakuumumgebung des Hohlraums wird entsprechend den Prozessanforderungen rotiert und das Gradientenwärmefeld und der Niederdruckzustand im Hohlraum müssen stabil gehalten werden. Wie in Abbildung 5 dargestellt, wird ein motorbetriebenes Zahnradpaar verwendet, um eine stabile Rotation des Tiegels zu erreichen. Um eine dynamische Abdichtung der rotierenden Welle zu erreichen, wird eine Magnetflüssigkeits-Dichtungsstruktur verwendet. Die magnetische Flüssigkeitsdichtung nutzt einen rotierenden Magnetfeldkreis, der zwischen dem Magneten, dem magnetischen Polschuh und der magnetischen Hülse gebildet wird, um die magnetische Flüssigkeit zwischen der Polschuhspitze und der Hülse fest zu adsorbieren und einen O-Ring-ähnlichen Flüssigkeitsring zu bilden, der vollständig blockiert die Lücke, um den Zweck der Abdichtung zu erreichen. Wenn die Drehbewegung von der Atmosphäre auf die Vakuumkammer übertragen wird, wird die dynamische Dichtungsvorrichtung mit flüssigem O-Ring verwendet, um die Nachteile des leichten Verschleißes und der geringen Lebensdauer bei der Feststoffdichtung zu überwinden, und die flüssige magnetische Flüssigkeit kann den gesamten abgedichteten Raum füllen. Dadurch werden alle Kanäle blockiert, aus denen Luft austreten kann, und bei den beiden Prozessen Tiegelbewegung und Anhalten wird keine Leckage mehr erreicht. Die magnetische Flüssigkeit und der Tiegelträger verfügen über eine wassergekühlte Struktur, um die Hochtemperatur-Einsetzbarkeit des magnetischen Fluids und des Tiegelträgers zu gewährleisten und die Stabilität des thermischen Feldzustands zu erreichen.

2.3 Hebemechanismus der unteren Abdeckung
Der Hebemechanismus der unteren Abdeckung besteht aus einem Antriebsmotor, einer Kugelumlaufspindel, einer Linearführung, einer Hebehalterung, einer Ofenabdeckung und einer Ofenabdeckungshalterung. Der Motor treibt die Ofenabdeckungshalterung an, die über ein Reduzierstück mit dem Schraubenführungspaar verbunden ist, um die Auf- und Abbewegung der unteren Abdeckung zu realisieren.
Der Hebemechanismus der unteren Abdeckung erleichtert das Einsetzen und Entfernen großer Tiegel und gewährleistet vor allem die zuverlässige Abdichtung der unteren Ofenabdeckung. Während des gesamten Prozesses gibt es in der Kammer Druckwechselstufen wie Vakuum, Hochdruck und Niederdruck. Der Kompressions- und Dichtzustand der unteren Abdeckung hat direkten Einfluss auf die Prozesssicherheit. Sobald die Dichtung bei hoher Temperatur versagt, wird der gesamte Prozess abgebrochen. Durch die Motorservosteuerung und die Begrenzungsvorrichtung wird die Dichtheit der unteren Abdeckungsbaugruppe und der Kammer gesteuert, um den besten Kompressions- und Abdichtungszustand des Ofenkammer-Dichtungsrings zu erreichen und so die Stabilität des Prozessdrucks sicherzustellen, wie in Abbildung 6 dargestellt .
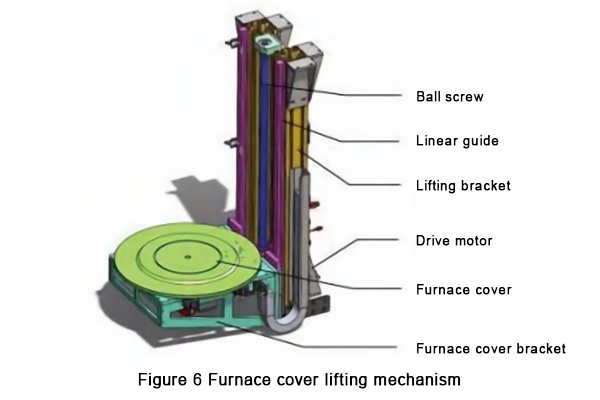
2.4 Elektrisches Steuersystem Während des Wachstums von Siliziumkarbidkristallen muss das elektrische Steuersystem verschiedene Prozessparameter genau steuern, darunter hauptsächlich die Spulenpositionshöhe, die Rotationsgeschwindigkeit des Tiegels, die Heizleistung und -temperatur, verschiedene spezielle Gaseinlassströme und die Öffnung von das Proportionalventil.
Wie in Abbildung 7 dargestellt, verwendet das Steuerungssystem eine programmierbare Steuerung als Server, die über den Bus mit dem Servotreiber verbunden ist, um die Bewegungssteuerung der Spule und des Tiegels zu realisieren; Es ist über die standardmäßige MobusRTU mit dem Temperaturregler und dem Durchflussregler verbunden, um eine Echtzeitsteuerung von Temperatur, Druck und speziellem Prozessgasfluss zu ermöglichen. Es stellt die Kommunikation mit der Konfigurationssoftware über Ethernet her, tauscht Systeminformationen in Echtzeit aus und zeigt verschiedene Prozessparameterinformationen auf dem Host-Computer an. Über die Mensch-Maschine-Schnittstelle tauschen Bediener, Prozesspersonal und Manager Informationen mit dem Leitsystem aus.

Das Steuerungssystem führt die gesamte Felddatenerfassung, die Analyse des Betriebsstatus aller Aktuatoren und die logische Beziehung zwischen den Mechanismen durch. Der programmierbare Controller empfängt die Anweisungen des Host-Computers und führt die Steuerung jedes Aktors des Systems durch. Die Ausführung und Sicherheitsstrategie des automatischen Prozessmenüs werden alle von der programmierbaren Steuerung ausgeführt. Die Stabilität der programmierbaren Steuerung gewährleistet die Stabilität und Sicherheit der Prozessmenübedienung.
Die obere Konfiguration pflegt den Datenaustausch mit der programmierbaren Steuerung in Echtzeit und zeigt Felddaten an. Es ist mit Bedienschnittstellen wie Heizungssteuerung, Drucksteuerung, Gaskreissteuerung und Motorsteuerung ausgestattet und die Einstellwerte verschiedener Parameter können über die Schnittstelle geändert werden. Echtzeitüberwachung der Alarmparameter, Bereitstellung einer Alarmanzeige auf dem Bildschirm, Aufzeichnung der Zeit und detaillierter Daten zum Auftreten und zur Wiederherstellung des Alarms. Echtzeitaufzeichnung aller Prozessdaten, Bildschirmbetriebsinhalte und Betriebszeit. Die Fusionssteuerung verschiedener Prozessparameter wird durch den zugrunde liegenden Code innerhalb der programmierbaren Steuerung realisiert, und es können maximal 100 Prozessschritte realisiert werden. Jeder Schritt umfasst mehr als ein Dutzend Prozessparameter wie Prozesslaufzeit, Zielleistung, Zieldruck, Argonfluss, Stickstofffluss, Wasserstofffluss, Tiegelposition und Tiegelgeschwindigkeit.
3 Wärmefeldsimulationsanalyse
Das Simulationsanalysemodell für thermische Felder wird erstellt. Abbildung 8 ist die Temperaturwolkenkarte in der Tiegelwachstumskammer. Um den Wachstumstemperaturbereich des 4H-SiC-Einkristalls sicherzustellen, wird die Mitteltemperatur des Impfkristalls mit 2200 °C und die Kantentemperatur mit 2205,4 °C berechnet. Zu diesem Zeitpunkt beträgt die mittlere Temperatur der Tiegeloberseite 2167,5℃ und die höchste Temperatur des Pulverbereichs (Seite nach unten) beträgt 2274,4℃, wodurch ein axialer Temperaturgradient entsteht.

Die radiale Gradientenverteilung des Kristalls ist in Abbildung 9 dargestellt. Der geringere seitliche Temperaturgradient der Impfkristalloberfläche kann die Kristallwachstumsform effektiv verbessern. Der aktuell berechnete anfängliche Temperaturunterschied beträgt 5,4 °C und die Gesamtform ist nahezu flach und leicht konvex, wodurch die Anforderungen an die Genauigkeit der radialen Temperaturregelung und die Gleichmäßigkeit der Oberfläche des Impfkristalls erfüllt werden können.

Die Temperaturdifferenzkurve zwischen der Rohmaterialoberfläche und der Impfkristalloberfläche ist in Abbildung 10 dargestellt. Die Mitteltemperatur der Materialoberfläche beträgt 2210℃, und zwischen der Materialoberfläche und dem Impfkristall bildet sich ein Längstemperaturgradient von 1℃/cm Kristalloberfläche, die in einem akzeptablen Bereich liegt.
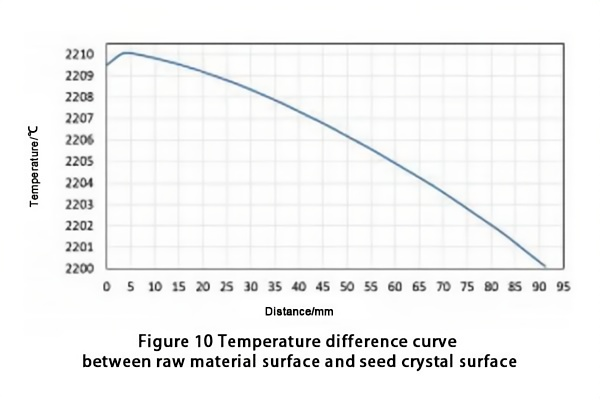
Die geschätzte Wachstumsrate ist in Abbildung 11 dargestellt. Eine zu schnelle Wachstumsrate kann die Wahrscheinlichkeit von Defekten wie Polymorphie und Versetzung erhöhen. Die derzeit geschätzte Wachstumsrate liegt bei etwa 0,1 mm/h, was in einem angemessenen Bereich liegt.

Durch thermische Feldsimulationsanalyse und -berechnung wurde festgestellt, dass die Mitteltemperatur und die Randtemperatur des Impfkristalls dem radialen Temperaturgradienten des Kristalls von 8 Zoll entsprechen. Gleichzeitig bilden Ober- und Unterseite des Tiegels einen axialen Temperaturgradienten, der der Länge und Dicke des Kristalls entspricht. Die aktuelle Heizmethode des Wachstumssystems kann das Wachstum von 8-Zoll-Einkristallen ermöglichen.
4 Experimenteller Test
Benutze diesSiliziumkarbid-Einkristall-ZüchtungsofenBasierend auf dem Temperaturgradienten der Wärmefeldsimulation wurde durch Anpassen der Parameter wie der Tiegeloberseitentemperatur, des Hohlraumdrucks, der Tiegelrotationsgeschwindigkeit und der relativen Position der oberen und unteren Spulen ein Siliziumkarbid-Kristallwachstumstest durchgeführt , und ein 8-Zoll-Siliziumkarbidkristall wurde erhalten (wie in Abbildung 12 gezeigt).

5. Schlussfolgerung
Die Schlüsseltechnologien für das Wachstum von 8-Zoll-Siliziumkarbid-Einkristallen, wie das Gradienten-Wärmefeld, der Tiegelbewegungsmechanismus und die automatische Steuerung der Prozessparameter, wurden untersucht. Das Wärmefeld in der Tiegelwachstumskammer wurde simuliert und analysiert, um den idealen Temperaturgradienten zu erhalten. Nach Tests kann die Doppelspulen-Induktionserwärmungsmethode dem Wachstum großer Größen gerecht werdenSiliziumkarbid-Kristalle. Die Forschung und Entwicklung dieser Technologie liefert Ausrüstungstechnologie für die Gewinnung von 8-Zoll-Karbidkristallen und stellt eine Ausrüstungsgrundlage für den Übergang der Siliziumkarbid-Industrialisierung von 6 Zoll auf 8 Zoll bereit, wodurch die Wachstumseffizienz von Siliziumkarbidmaterialien verbessert und die Kosten gesenkt werden.



